毕思涵 宋建军 张栋 张士琦
1) (西安电子科技大学微电子学院,宽禁带半导体重点实验室,西安 710071)
2) (中国航天科技集团有限公司抗辐射集成电路技术实验室,西安 710071)
整流器件是微波无线能量传输系统的核心部分,新型整流器件的研发是当前领域研究的重要方向.肖特基二极管和场效应晶体管是目前主流整流器件,但二者整流范围有限,无法实现兼顾弱能量和中等能量密度的宽范围整流.有鉴于此,本文提出并设计了2.45 GHz 微波无线能量传输用Ge 基p 型单端肖特基势垒场效应晶体管(源端为肖特基接触,漏端为标准p+掺杂).在此基础上,充分利用器件的肖特基结构,采用新型二极管连接方式,以实现不同偏压下开启的沟道和源衬肖特基结构的双通道宽范围整流.采用Silvaco TCAD 软件进行仿真,对于负载为0.3 pF 和70 kΩ 的半波整流电路,实现了—20—24 dBm 宽范围整流,相比同条件下Ge场效应晶体管范围拓宽8 dBm,且在范围内整体整流效率较高,在16 dBm 整流效率峰值可达57.27%.在—10 dBm弱能量密度的整流效率达到6.17%,是同等条件下Ge 场效应晶体管的7 倍多.
微波无线能量传输系统是一种突破了传输线的限制,通过天线发射和接收微波信号,将射频信号(RF)转化为直流(DC)信号的系统.2.45 GHz射频信号为我国环境中主要射频信号源,若采用微波无线能量传输系统来传输该波段信号,可以解决电池供电寿命短和初始成本高的问题,且在医疗、便携式可穿戴设备等领域有广阔的应用前景[1-4].
目前,在微波无线能量传输领域,国际研究者大多专注于阵列整流天线设计和整流电路优化提升,而对新型整流器件的探索研究较少[5-7].肖特基二极管和CMOS 是主流的整流器件,国内外对二者研究颇多,但想实现从弱能量到中等能量密度的宽范围整流仍存在困难[8-10].器件的整流范围越宽,对应正常工作时允许的输入电压范围就越大,实际应用的场景就更加广泛.因此,通过新型整流器件来拓宽整流范围,提升系统的整流性能,是重要的研究方向.
传统的肖特基势垒场效应晶体管(Schottky barrier-MOSFET,SB-MOSFET)很好融合了MOSFET 与肖特基结构,若采用新型连接方式可实现沟道和源衬肖特基结构的双通道宽范围整流.但SB-MOSFET 具有输出电流小和反向泄漏电流明显的缺点,限制了整流效率的提升[11].而源端为肖特基接触,漏端为标准p+掺杂的单端肖特基势垒场效应晶体管(Schottky barrier source left-MOSFET,SBSL-MOSFET),载流子在输运时无需再翻越漏端肖特基势垒,从而增大了沟道电流,提高了整流效率.当前国际的研究主要集中于通过工艺改善SB-MOSFET 的导通电流,而在整流应用方面少有研究,因此SBSL-MOSFET 双通道整流的提出将弥补该器件在整流领域的空白[12,13].
有鉴于此,本文提出并设计了用于2.45 GHz 微波无线能量传输的Ge 基p 型双通道整流SBSLMOSFET,以实现宽范围的整流.首先,在传统SBMOSFET 基础上分析了SBSL-MOSFET 的工作机理和电流输运,设计了Ge 基p 型SBSL-MOSFET.之后仿真分析了器件的I-V特性,并提出新型连接方法下实现器件的双通道宽范围整流.最后利用Silvaco TCAD 软件的MixedMode 搭建半波整流电路,比较SBSL-MOSFET 与几种MOSFET 的整流性能,证实了所设计的SBSL-MOSFET 解决了传统器件整流范围较小的问题.
2.1 基本输运机理
肖特基势垒场效应晶体管设计的重点在于源(漏)端肖特基接触金属的选取.对于传统的p 沟道Ge 基SB-MOSFET 选取NiGe 作为源漏端金属,而SBSL-MOSFET 选取NiGe 作为源端金属,漏端为p 型掺杂.由于Ge 价带附近费米能级钉扎的存在,在器件关断时,NiGe 与沟道n-Ge 接触为肖特基接触,有较高的电子势垒(约0.56 eV),而在沟道反型后,器件开启,NiGe 与p-Ge 接触体现出欧姆特性,空穴势垒低(约0.1 eV)[14,15].
对传统的SB-MOSFET 工作机理进行分析,图1 是p 沟SB-MOSFET 表面随栅压(Vg)和漏压(Vd)变化的能带图.如图1(a)所示为器件的关断状态,此时栅压和漏压都为0 V 时,源漏端的NiGe 与沟道n-Ge 接触,势垒高,载流子很难通过,其中Φbn为电子势垒高度,Φbp为空穴势垒高度.图1(b)展现了器件的反向泄漏,当栅压为0 V,漏端有偏压时电子有一定概率隧穿通过肖特基势垒进入沟道区,形成反向泄漏电流,高电子势垒确保这一反向泄漏电流远小于正向导通电流,但仍是较显著的现象.如图1(c)随着栅压增大,当电子势垒等于本征势垒高度时,势垒消失,此时电流主要以空穴热电子发射为主,器件处于亚阈值状态,尚未完全开启,电流较小.如图1(d)当栅压一直增大至阈值电压时沟道反型,源漏端NiGe 与反型形成的p-Ge 接触,空穴势垒小,且栅压越大势垒宽度越窄,空穴隧穿概率增加,大量空穴可由隧穿机制从源极运动到漏极,为载流子主要输运方式,且伴随有少量空穴通过热电子发射翻越势垒,器件开启.

图1 Ge 基p 沟SB-MOSFET 随外 加电压变化的能带图 (a) |Vg|=|Vd|=0;(b) |Vg|=0,|Vd|>0;(c) |Vg|<|VT|;(d)|Vg|>|VT|Fig.1.Energy band diagram of Ge based p-channel SB-MOSFET with applied voltage: (a) |Vg|=|Vd|=0;(b) |Vg|=0,|Vd|>0;(c) |Vg|<|VT|;(d) |Vg|>|VT|.
图2为在传统SB-MOSFET 基础上设计的SBSL-MOSFET 能带图,不同之处在于漏端采用p+掺杂代替了肖特基结构.图2(a)器件关断状态,栅压和漏压都为0 V,源端为NiGe 与n-Ge 接触的高势垒,漏端为pn 结势垒,载流子无法通过.图2(b)当栅压达到阈值电压,沟道反型,源端为NiGe 与p-Ge 接触的低空穴势垒,且漏端势垒降低.空穴由隧穿机制从源端进入沟道后继续向漏端运动,在漏端不再需要翻越或隧穿通过势垒,从而增大了沟道电流.同时,漏端换为p+掺杂也解决了肖特基漏端反向隧穿泄漏电流显著的问题.

图2 Ge 基p 沟SBSL-MOSFET 随外加电压变化的能带图 (a) |Vg|=|Vd|=0;(b)|Vg|>|VT|Fig.2.Energy band diagram of Ge based p-channel SBSL-MOSFET with applied voltage: (a) |Vg|=|Vd|=0;(b) |Vg|>|VT|.
2.2 电流输运方程
当SBSL-MOSFET 的沟道未完全反型时,价带高度低于势垒高度,由于较宽的势垒耗尽区,无法发生载流子隧穿,此时载流子的输运方式以能量较高的载流子越过势垒即热电子发射机制为主.而当SBSL-MOSFET 的沟道完全反型后,势垒变薄,隧穿概率增大,此时载流子输运以隧穿机制为主.
当载流子的能量足够高时,就有越过肖特基势垒的概率.假设势垒的高度远高于k0T,能够近似使用麦克斯韦-玻尔兹曼理论,利用热电子发射理论,则电子从半导体扩散到金属中的电流密度为[16]

而从金属扩散到半导体中的电流密度是Js→m是一个常数,由此可得出肖特基结构总电流密度公式为

式中

当SBSL-MOSFET 沟道反型后,外加栅压使得肖特基势垒变薄,此时隧穿机制为载流子主要输运方式.(1) 式此时需考虑热电子发射和隧穿机制的共同作用,将 (1) 式修改为[17]

考虑量子力学中半经典WKB 近似算法,可得载流子隧穿概率为

当能量ξ满足 0 <ξ<qB时载流子输运以隧穿通过势垒为主,当ξ >qB时载流子输运以热电子发射为主.
考虑到器件工作时,金属和半导体间受正反偏压的影响,同时考虑热电子发射和隧穿机制,可将(5) 式修改为

若积分限取0 到势垒高度q(VD-V),表达式为隧穿电流,积分限取q(VD-V) 到正无穷则为载流子翻越势垒的热电子发射电流.当式中V >0 时为正向电流,V<0为反向电流.
2.3 器件结构设计及特性仿真
肖特基势垒场效应晶体管的结构和特性会受如源(漏)金属选择、栅氧化层厚度、衬底掺杂浓度、栅材料选取等多个参数的影响.基于2.1 节理论,本文设计的用于对照的传统p 沟道SB-MOSFET选取NiGe 合金作为源漏,NiGe 与n-Ge 接触电子势垒高度为0.56 eV,栅材料选用重掺杂多晶硅栅(NA=1×1021cm-3).
以使器件具有低的阈值电压,栅氧化层选取高介电常数的HfO2且厚度为7 nm,衬底为n-Ge 掺杂浓度 2×1016cm-3.在此基础上设计的SBSLMOSFET 除了漏端采用传统的p+掺杂Ge(NA=2×1019cm-3),其余参数与SB-MOSFET 相同.图3 绘制了上述两个肖特基势垒场效应晶体管的结构并标出了仿真使用的参数,SBSL-MOSFET的栅宽W=5 µm、栅长L=1 µm、栅氧化层厚度tox=7 nm、源(漏)厚度d=10 nm、衬底掺杂浓度NB=2×1016cm—3、漏端掺杂浓度NA=2×1019cm—3.

图3 SB-MOSFET (a) 和 SBSL-MOSFET (b)器件结构及仿真用关键参数值Fig.3.The key parameter values for device structure and simulation of SB-MOSFET (a) and SBSL-MOSFET (b).
本文选取Silvaco TCAD 来仿真肖特基势垒场效应晶体管,仿真模型建立的关键在于物理模型的选取.对于源(漏)肖特基结构,选取通用肖特基隧穿(UST)模型.在UST 模型中,隧道电流由肖特基触点附近网格位置的局部隧穿概率表示,将不同势垒高度载流子隧穿概率与其浓度相乘,再积分得到总电流.迁移率模型选取Lombardi,将肖特基势垒场效应晶体管的温度、衬底掺杂浓度和温度对迁移率的影响组合计算.图4为Ge 基SB-MOSFET和SBSL-MOSFET 结构模拟图,两器件的各项参数在上文给出,且再选取Ge MOSFET 作为对照组,源漏掺杂浓度(NA=2×1019cm—3),其余参数与肖特基势垒场效应晶体管保持一致.
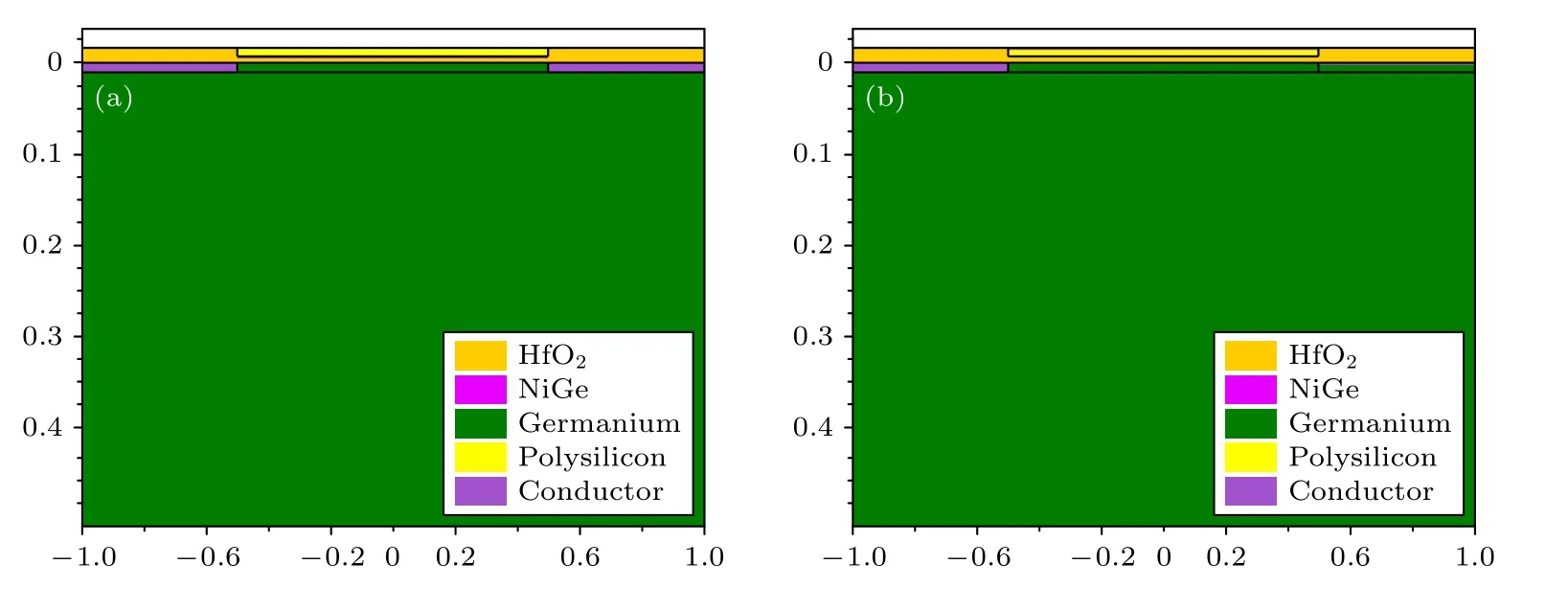
图4 Ge SB-MOSFET (a)和 Ge SBSL-MOSFET (b)仿真结构图Fig.4.The simulation structure diagram of Ge SB-MOSFET (a) and SBSL-MOSFET (b).
图5为Ge MOSFET、Ge SB-MOSFET 和Ge SBSL-MOSFET 在漏源电压VDS=—0.1 V 时仿真得到的转移特性曲线图,其中图5(a)为普通坐标系,图5(b)为对数坐标系.由图5(a)所示,使用重掺杂多晶硅栅的SB-MOSFET 和SBSL-MOSFET 阈值电压低于传统的MOSFET,提取传统的MOSFET阈值为0.41 V,SB-MOSFET 阈值为65.31 mV,SBSL-MOSFET 阈值电压为0.124 V,由于SBSLMOSFET 漏端没有LDD 区域,所以其阈值会略高于SB-MOSFET.器件能够低栅压下开启利于在弱能量密度的整流应用,但也会导致静态功耗上升和低电平噪声容限的下降等问题.由图5(b)所示SB-MOSFET 有明显的电子反向结泄漏电流,这是SB-MOSFET 的一个明显缺陷.这种反向漏电流的大小依赖于漏极偏压,降低了器件的关断能力,而SBSL-MOSFET 采用传统掺杂漏端解决了这一问题,泄漏电流大幅度减小.

图5 标准坐标系(a)和对数坐标系下(b)三种MOSFET的转移特性曲线图Fig.5.Transfer characteristic curves of three MOSFETs in the standard coordinate system (a) and the logarithmic coordinate system (b).
图6为SB-MOSFET 和SBSL-MOSFET 在栅压Vg=0——0.6 V 的输出特性曲线图.改进后的SBSL-MOSFET 输出电流明显大于相同偏压下的SB-MOSFET,增强了器件的输出性能,利于整流性能的提高.

图6 SB-MOSFET 和SBSL-MOSFET 输出特性曲线图Fig.6.Output characteristic curves of SB-MOSFET and SBSL-MOSFET.
图7为传统Ge-MOSFET 的输出特性曲线图.由于SB-MOSFET 和SBSL-MOSFET 阈值电压低,在栅压Vg=—0.2 V 已经开启,有显著电流,而阈值电压较高的传统 MOSFET 还没开启.相同栅压下,由于源端载流子输运的隧道效应受隧穿概率的影响,SB-MOSFET 和SBSL-MOSFET 的输出电流小于传统的MOSFET,这会影响器件的整流效率,因此后续研究采用新型连接方法增大输出电流,从而弥补沟道隧穿电流小的缺点.

图7 Ge-MOSFET 输出特性曲线图Fig.7.Output characteristic curve of Ge-MOSFET.
3.1 新型器件连接方法
在2.45 GHz 微波无线能量信号收集时,—10 dBm弱能量密度的射频输入功率通常很低,在50 Ω 阻抗下的等效输入振幅仅为100 mV.有鉴于此,整流器件若想实现较宽范围的整流,需要具备极低的开启电压,否则接收到的弱能量密度的射频信号不足以使之开启,限制器件整流应用范围.本文设计的SBSL-MOSFET 开启电压低,相比传统MOS在弱能量密度下有更高的整流效率.为了实现较宽范围的整流,进一步提高器件的输出电流,抑制反向泄漏电流,本文采用栅、漏、衬底三端相连作为输入端,源极作为输出端的新型二极管连接方法,以实现沟道和源衬肖特基结构的双通道整流.
图8为能实现整流功能的传统二极管连接方式的SBSL-MOSFET 电流示意图.栅极与漏极连接作为等效输入端,源极和衬底相连作为等效输出端.在正向偏置条件下,器件开启,漏衬pn 结处于反偏状态,载流子很难通过势垒从而形成电流,因此只存在沟道导通的电流.而在反向偏置条件下,漏衬pn 结导通,器件产生大的反向电流,器件无法完全关断,影响整流效率的提升.

图8 传统二极管连接方式SBSL-MOSFET 电流示意图 (a) 正向电流;(b) 反向电流Fig.8.Conventional diode connection of SBSL-MOSFET current diagram: (a) Forward current;(b) reverse current.
图9为SBSL-MOSFET 的新型二极管连接方式[18,19].新型连接方式下将栅极、漏极和衬底三端相连作为等效输入,源极作为等效输出.在正向偏置条件下低阈值的沟道一路先导通,随后加正偏压的源衬NiGe/n-Ge 肖特基结构达到开启电压导通,肖特基结构的电流和沟道电流共同起作用,能够提供大的正向导通电流.而在反向偏置条件下漏衬pn 结两端偏压相同,有极低的反向泄漏电流.因此,与传统二极管连接方式相比,新型连接方式的SBSL-MOSFET 增大了总输出电流,抑制了反向泄漏电流.器件在正向偏置条件下开启,反向偏置条件下关断,实现了沟道和源衬肖特基结构的双通道整流,在2.45 GHz 微波无线能量信号的收集能力显著提升.
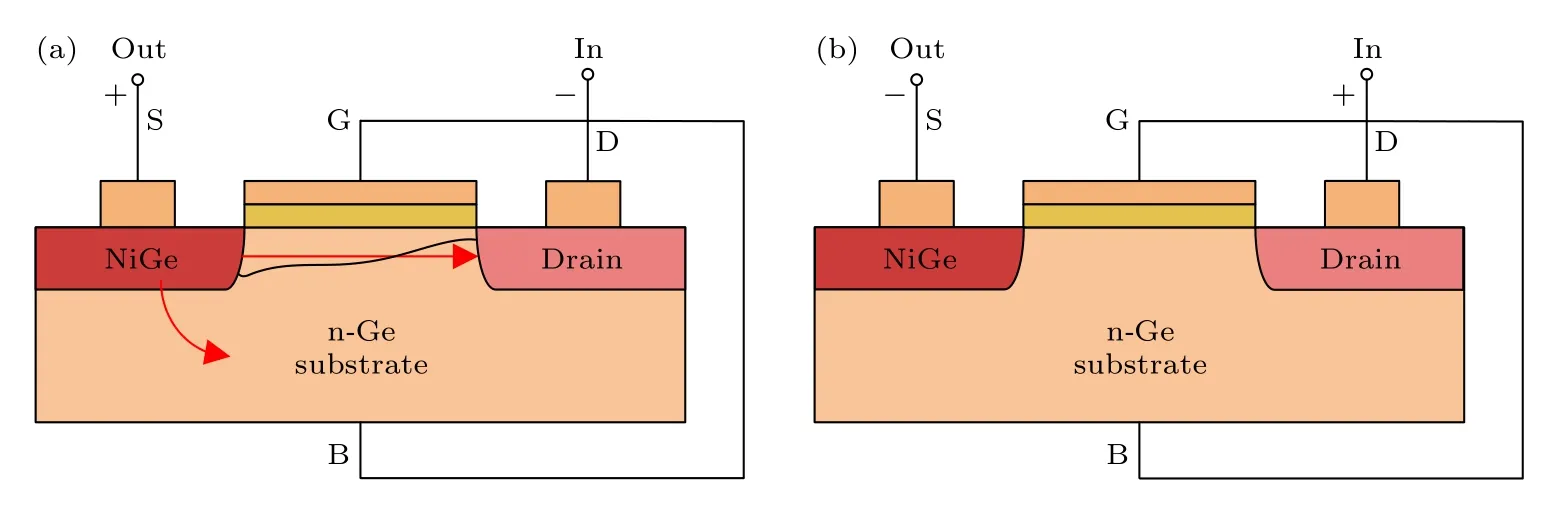
图9 新型连接方式SBSL-MOSFET 电流示意图 (a) 正向电流;(b) 反向电流Fig.9.Novel connection of SBSL-MOSFET current diagram: (a) Forward current;(b) reverse current.
3.2 半波整流电路搭建
本文搭建了如图10 所示半波整流电路来分析和仿真SBSL-MOSFET 在2.45 GHz 微波无线能量收集的整流性能.器件采用3.1 节所述两种连接方式,可等效为二极管,正向偏置半周期下器件导通,反向偏置半周期下器件关断,将交流电转化为脉动直流电.电路中采用交流电压源,信号频率2.45 GHz,电源内阻R为50 Ω.R1为负载电阻,C1为负载电容,用来稳压和平滑输出信号[20].
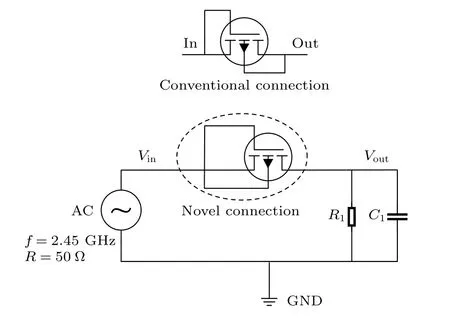
图10 半波整流电路示意图Fig.10.The schematic diagram of half wave rectifier circuit.
3.3 DC 仿真
图11为Ge 基SBSL-MOSFET 在两种连接方式下DC 仿真的I-V曲线图.当器件在外加负压时,若采用新型连接方法,从局部放大图可看出,沟道在低阈值电压下优先开启(电流为ID),随后源衬肖特基结构正偏开启(电流为Isub),而器件在外加正压时两路关断,实现了双通道整流,利于整流范围的拓宽.如图当偏压为—1 V 时,在源衬NiGe/n-Ge 肖特基结构导通电流和沟道电流的共同作用下,增大了总输出电流.而传统连接方式下源衬肖特基结构不导通,无法对输出电流做出贡献.当外加正压1 V 时,传统连接方式泄漏电流ID为新型连接方式的59 倍,可见采用新型连接方式大幅度降低了泄漏电流,利于器件即时关断,提高了整流性能.
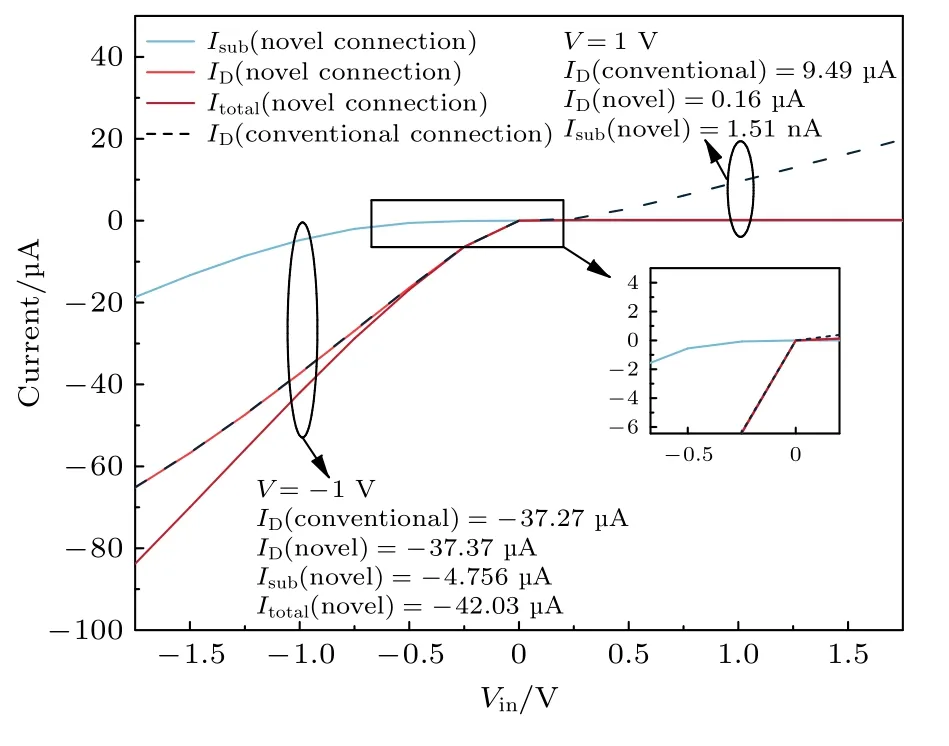
图11 Ge 基SBSL-MOSFET 在两种连接方式下的I-V 曲线图Fig.11.I-V curve diagram under two connection methods of Ge based SBSL-MOSFET.
图12为SB-MOSFET 和SBSL-MOSFET 在新型连接方法下DC 仿真的I-V曲线图.如图外加偏压为—1 V 时,两种器件的源衬肖特基导通电流相差不大,而SBSL-MOSFET 沟道电流ID相比SB-MOSFET 有显著提升,使得总输出电流增大了12.17 µA,利于整流效率的提升.
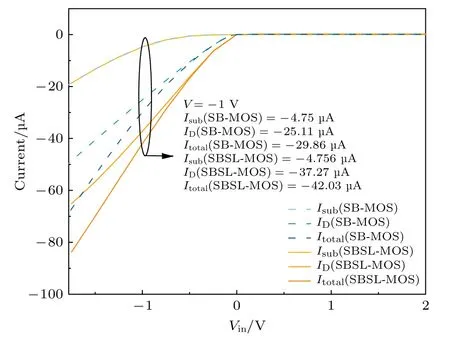
图12 SB-MOSFET 和SBSL-MOSFET 在新型连接方式下I-V 曲线图Fig.12.I-V curve diagram under the new connection method of SB-MOSFET and SBSL-MOSFET.
3.4 瞬态仿真
对搭建的半波整流电路进行MixedMode 瞬态仿真以分析器件的整流性能.整流效率是衡量器件整流性能的关键指标,表示了微波无线能量传输系统将输入射频功率转换为直流输出能量的能力.整流效率越高,输出的可供负载利用的能量就越多,其计算方法为:

计算一个周期的整流效率,需将此周期的输出输入功率积分算出并相比:

图13(a)为电路瞬态仿真达到稳态时的波形图,选取23.57—25.2 ns 的稳定波形,输入电源为2.45 GHz 交流电压源,内阻50 Ω,电压峰峰值为2 V,负载电阻70 kΩ,负载电容0.3 pF.从图13(a)中可看出输入的交流信号在经过SBSL-MOSFET整流电路后变为脉动直流信号,器件有较好的整流功能.图13(b)为单个周期输入输出电压局部放大图.其中ΔV为输出脉动电压变化幅度,ΔV越小说明输出直流信号越稳定.图13(c)为由电压电流计算绘制的瞬态输入输出功率图,将一个周期内输出和输入功率相比即可计算出整流效率.图13(d)为整流效率和负载电压随阻抗变化图.使用上述交流电压源和负载电容电阻计算出整流效率为45.64%,综合考虑整流效率和负载电压,70 kΩ 负载电阻和0.3 pF 负载电容搭配为整流电路最佳负载搭配.

图13 (a) 瞬态仿真输入输出电流电压波形图;(b) 瞬态仿真输入输出电压单周期局部放大图;(c) 瞬态仿真输入输出功率图;(d) 整流效率和负载电压随负载阻抗变化图Fig.13.(a) Transient simulation input and output current and voltage waveforms;(b) transient simulation input and output voltage single-cycle partial enlarged diagram;(c) transient simulation input and output power diagrams;(d) rectification efficiency and load voltage with load impedance change graph.
图14为SB-MOSFET 和SBSL-MOSFET 整流效率曲线图.两种器件在—20 dBm 沟道开启整流,在5.56 dBm 源衬肖特基结构一路导通,双路协同整流,从而拓宽了整流范围.改进后的SBSLMOSFET 输出电流增大,泄漏电流减小,整流效率相比SB-MOSFET 整体显著提高.在—10 dBm弱能量密度区域整流效率提升3.74%,在16 dBm整流效率峰值达到57.27%,提升了6.62%.

图14 SB-MOSFET 和SBSL-MOSFET 整流效率曲线图Fig.14.Rectifying efficiency graph of SB-MOSFET and SBSL-MOSFET.
图15为SB-MOSFET,SBSL-MOSFET,Ge-MOSFET,QS-MOSFET四种MOSFET 的整流效率曲线图,图中标出了几种器件的整流范围,其中QS-MOSFET为文献报道的弱能量密度用整流器件[20].SBSL-MOSFET 的优势在于低阈值电压优先开启的沟道一路可以和QS-MOSFET 一样在弱能量密度(—10 dBm)整流,整流效率达到了6.17%,是传统Ge-MOSFET 整流效率的7 倍多,而此时传统Ge-MOSFET 整流效率过低,无法很好整流.随后开启的源衬肖特基一路使得SBSL-MOSFET整流效率不至于像QS-MOSFET 在不到15 dBm就降低至近0,拓宽了器件的整流范围,实现了—20—24 dBm 宽范围整流,范围相比同条件Ge-MOSFET 拓宽8 dBm,比QS-MOSFET 拓宽约10.5 dBm,且整体整流效率保持较高水平.
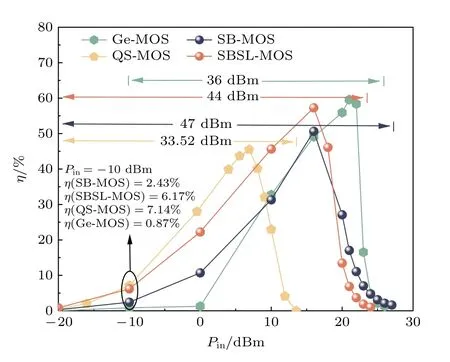
图15 四种MOSFET 整流效率曲线图Fig.15.Rectifying efficiency graphs of four kinds of MOSFET.
本文提出并设计Ge 基p 型用于2.45 GHz 微波无限能量传输的SBSL-MOSFET.仿真结果表明: 相比传统的SB-MOSFET,SBSL-MOSFET 提高了输出电流,减小了泄漏电流,提升了整流性能.为了拓宽器件的整流范围,采用了新型连接方式,实现了沟道一路先开启和源衬肖特基结构一路后开启的双通道整流.从直流和瞬态模拟方面分析了SBSL-MOSFET 相对于传统SB-MOSFET 的优势,实现了—20—24 dBm 宽范围整流,在16 dBm整流效率峰值达到57.27%,整流效率相对于SBMOSFET 整体提升,且在—10 dBm 弱能量密度整流效率达到6.17%,是同等条件下SB-MOSFET的2.5 倍,Ge-MOSFET 的7 倍多,充分说明了该器件的优势.
猜你喜欢 曲线图器件电流 Finding the Extraterrestrial考试与评价·高一版(2020年2期)2020-10-29标定电流与额定最大电流的探讨新课程·中旬(2017年7期)2017-08-13高中地理图像图表题解析技巧之管窥课程教育研究·下(2016年12期)2017-04-26曲线图在高中生物教学中的应用新课程·中学(2017年1期)2017-03-23交变电流基本知识汇总中学生数理化·高二版(2016年5期)2016-05-14交变电流高考真题赏析中学生数理化·高二版(2016年5期)2016-05-14解答《经济生活》曲线图试题的四大技巧广西教育·B版(2016年1期)2016-03-14挑战眼力青少年科技博览(中学版)(2013年4期)2013-10-09通用贴片式器件及应用电路(五)电压变换器MAX860及MAX881R电子世界(2004年5期)2004-07-26